Any Layer기판
제품에 적합한 Laminate / Multi Layer / Any Layer 구조 제안
휴대전화나 DSC 등의 소비자 용도에서 휴대폰 무선 통신 기지국 등 시스템 용도까지 부품의 고밀도 실장 요구에 대응할 수 있는 초미세 배선을 실현하는 Build up 기판을 제공합니다.
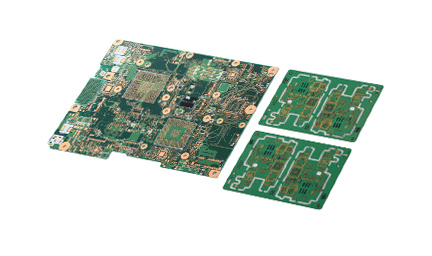
특징
- 75μm 이하의 미세한 회로 패턴을 실현 (40μm 대응 가능)
- Via-on-Via, Via-on-IVH 등에 의한 배선 자유도가 향상
- 100μm이하의 미세Via Hole 실현으로 인해 Land직경 축소
- Stack Via와 박형화 지원을 통해 Any Layer 구조 / 초 고밀도 실장을 실현
- Via부의 Filled plating처리에 의해 접속 신뢰성이 향상
- 층간 두께 및 도금의 안정화에 의해 임피던스 정확도 향상
- Peel강도의 향상으로 부품의 수리도 가능
- 적층기술 및 고내열 기재와의 조합으로 자동차관련 기기에 최적의 제안 가능
기본사양
| 항목 | 사양 | |
|---|---|---|
| Build up 회수(Max) | 4 | |
| L/S(Min) | 내층 | 40/40μm |
| 외층 | 50/50μm(40/40μm) | |
| Via size/Land size(LVH) | 75/150μm | |
| 최소 Pad폭/Pad간 폭 | 50/50μm | |
| Core두께(Min) | 0.04mm | |
| 절연층 간 두께(Min) | 0.03mm | |
| 총 두께 | 3-2-3 | 0.45mm |
| 4-2-4 | 0.55mm | |
구조Image
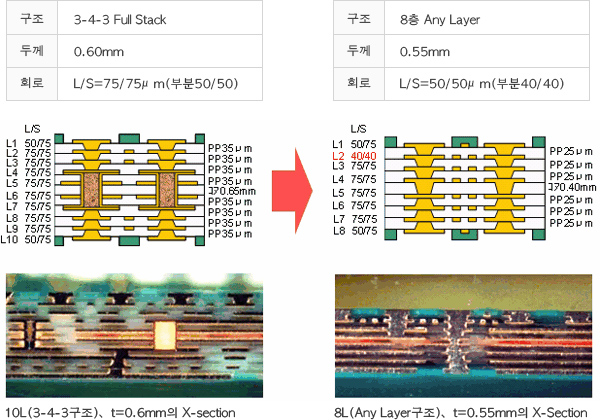

제품용도
- 휴대전화
- Digital Video Camera
- 휴대전화용 무선기지국
- High-end server
- 의료기기
- 고밀도 실장이나 고 신뢰성이 필요한 제품
고다층기판
기술력으로 축적된 고신뢰성 다층 기판의 제공
고밀도화 기술 및 고다층 적층기술은 고정밀 고화질 배선 및 높은 비율을 실현한 최첨단 고밀도 다층기판을 제공합니다.
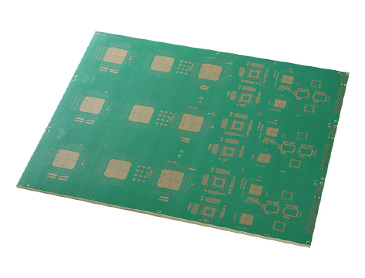
특징
- 드릴링, 도금 기술의 확립에 의한 고 종횡비 제품의 실현
- 정밀 등록 기술에 의해 여러 차례 적층 접합 기판에 대응
- 콘덴서 기능 내장으로 구현 효율성과 기능성 강화 실현
- 빌드 업 기술의 융합으로 고 다층 기판에서 더욱 고밀도 실장이 가능
- 고정밀 패터닝으로 정밀 임피던스 컨트롤이 가능
- Back drilling추가에 따라 전기 특성에 효과 발휘
기본사양
| 항목 | 사양 | 비고 |
|---|---|---|
| 층수 | 4~50층 이상 | 고 다층 다중 적층 기판 |
| 두께 | 0.4~7.0mm | 0.06mm Core재료 대응 가능 |
| (BC재료0.025mm) | ||
| 재질 | FR-4、FR-5 해당재료 기타 | 각종 저 유전 재료, BT 레진, 폴리미드 |
| Build up회수 | 3 | SkipVia 대응 가능 |
| 최대기판 크기 | 477×699mm | |
| 최대종횡비 | 20 | |
| Through hole | BVH、IVH 가능 | Via구조:IVH on 2단Stack |
| L/S(Min) | 80/100μm(외층) | 75/75μm(내층) |
| Back drill | Drill직경+0.15mm | 특수사양 |
구조Image
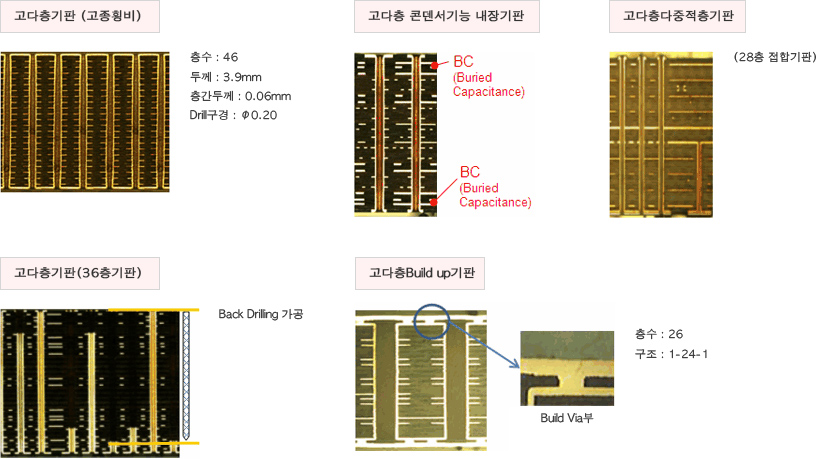
제품용도
- 대형 컴퓨터
- 컴퓨터 주변 기기
- 통신기기
- 계측기기
- 기지국